Grinding and Chemical Mechanical Polishing Applications in Advanced Packaging

Xinchun Lu
Hwatsing Technology Co.,Ltd



Xinchun Lu
Hwatsing Technology Co.,Ltd


Taesung Kim
Sungkyunkwan University


Yijie Luo
HUBEI DINGLONG CO.LTD.


Liang Tian
Semiconductor Manufacturing North China ( Beijing ) Corp ,China


Zhenxiang Huang
China University of Mining & Technology-Beijing


Chen Chao
Beijing NAURA Technology Group Co., Ltd.


Yu Li
ACM


Guanghong Luo
Yantai Xianhua Polymer Materials Ltd.


Yu Yao
Semiconductor Technology Innovation Center (Beijing) Corporation, Beijing, China


Mingtao Luo
Applied Materials


Zheng Wu
Hebei University of Technology


Yu Yang
Shanghai Huali Integrated Circuit Corporation


Jialiang Huang
Anji Microelectronics Technology (Shanghai) Co., Ltd.


Wei Yuan
Fudan University


Zhiwei Zhang
Zhejiang University


Bin Hu
Hebei University of Technology


Wenhao Xian
Hebei University of Technology


Yafei Yin
Hebei University of Technology


Ziyi Cao
Hebei University of Technology
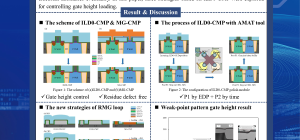

Shuxiang Wang
Shanghai Huali Integrated Circuit Corp


Cheng Liu
Shanghai Huali Integrated Circuit Corporation


Cheng Liu
Shanghai Huali Integrated Circuit Corporation


Zian Ba
Hebei University of Technology


Lijun Dong
Hebei University of Technology


Yongbin Wei
Applied Materials


Hyunho Kim
Sungkyunkwan University


Jiahui Li
Hebei University of Technology


Jitao Chen
Shanghai Huali Integrated Circuit Corporation


Wangbing Li
Shanghai Huali Integrated Circuit Corporation


Likun Cheng
Applied Materials (China) Inc


Yifeng Zheng
Applied Materials


Zhenxing Song
Applied Materials (China)


Yuan Li
Applied Materials


Ben Gu
Applied Materials


Weihan Zhu
Applied Materials


Mingzheng Han
Applied Materials


Wanli Xing
Applied Materials


Yanjun Yu
Applied Materials


Jiaming Xu
Applied Materials (China)


Qiang Chen
Applied Materila China


Ming Zeng
Beijing Superstring Academy of Memory Technology


Tao Ni
Applied Materials (China), Inc.China
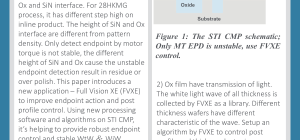

Mengyao Liu
Applied Materials


Siyuan Pang
Applied materials


Haodong Huang
Applied materials


Mengxia Li
Applied material


Kun Zhang
Applied Materials China
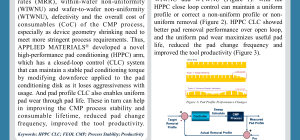

Na Xiao
Applied Materials China


Weiguo Wang
Applied Materials


Kewen Wang
Applied Materials China
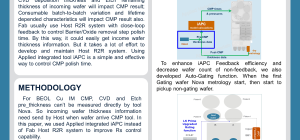

Youlai Xiang
Applied Materials China
© 2022 SEMI Cloud. All Rights Reserved.