Advanced Packaging Architectures for Advanced Heterogeneous Integration (HI)

Ravi Mahajan
Intel

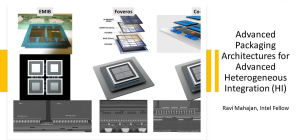

Ravi Mahajan
Intel


TORU FUJIMORI
FUJIFILM Corporation


Jara Garcia Santaclara
ASML


Lucia D’Urzo
Pall


Runhui Huang
Brewer Science Inc.


AO CHEN
Mentor, a Siemens Business


Rui Hu
ICRD


Yan Yan
ICRD


Qian Xie
Mentor, a Siemens Business


Leo Pang
D2S


Yongqiang Hou
ICRD


Hakaru Mizoguchi
Gigaphoton


Stephen Renwick
Nikon Research Corp of America


Keita Sakai
Canon Inc.


Huigao Duan
Hunan University


Xue Huang
YMTC


Peter Henriksson
Mycronic AB


Masami Ikota
Hitachi High-Tech Corp.


Masahiko OKUMURA
Nikon Corporation


Hao Jiang
Huazhong University of Science and Technology


Chen Lijun
Shanghai Huali Microelectronics Corporation


Zheng Haichang
Shanghai Huali Microelectronics Corporation


Li Chen
Shanghai IC R&D Center


Minxiang Wang
Lam Research Service Co., Ltd
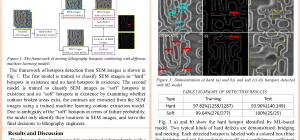

Zhou Tao
Shanghai IC R&D Center
© 2021 SEMI 云官网. All Rights Reserved.