From "Iso-Dense" Biasing to "Inverse Lithography:" Milestones in Optical Proximity Correction Technology

Michael Rieger
Synopsys (retired)



Michael Rieger
Synopsys (retired)


Allen Chang
JSR


David Xiao
Qianmo Microelectronics


Ken Wu
Fudan University


Hideaki Tsubaki
FUJIFILM Corporation


Yanli Li
Fudan University


Qi Wang
Fudan University


Ying Li
Fudan University


Haoyong Wang
Fudan University


Yijiang Shen
Guangdong University of Technology


Fei Ai
University of Chinese Academy of Sciences


Jamin Liu
Huazhong University of Science and Technology


Guangyuan Zhao
Hongkong Chinese University


Jiang Yan
Fudan University


Lei Wang
Shanghai Huahong Grace Semiconductor Manufacturing Corporation


Kan Zhou
Shanghai Huali Integrated Circuit Corp


Weimei Xie
NICIC


Robert Eklund
Mycronic AB


Martin Glimtoft
Mycronic AB


Xianhe Liu
Fudan University


Masao Tomikawa
Toray Industries Inc


David H. Wei
Quantica Computing, LLC


Shaopeng Guo
Huazhong University of Science and Technology


Liejie Huang
Zhejiang University


Zhiwei Ren
Fudan University


Chaoyi Zheng
Zhejiang University


Jibin He
Zhejiang University


Tianhao Huang
Zhejiang University


Delong Yao,
EDA Center, Institute of Microelectronics, Chinese Academy of Sciences


Jinjie Li
University of Chinese Academy of Sciences
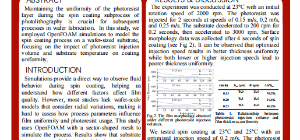

Pan Liu
Zhejiang University


Huiyun Jiang
Zhejiang University


Qing Li
Shanghai Huali Integrated Circuit Manufacturing Corporation


Li Xiao
Shanghai Huali Integrated Circuit Corporation
© 2022 SEMI 云官网. All Rights Reserved.