From "Iso-Dense" Biasing to "Inverse Lithography:" Milestones in Optical Proximity Correction Technology

Michael Rieger
Synopsys(retired)



Michael Rieger
Synopsys(retired)


Allen(Cheng Yao) Chang
JSR


David Xiao
Qianmo Microelectronics


Hongbo Sun
Beijing Chaoxian Memory Research Institute


Chia Lin Lu
Applied Materials


Fansheng Wang
Applied Materials China


Masaru Izawa
Hitachi High-Tech Corporation


Jiasheng Sun
Suzhou Youlun Vacuum Equipment Technology Co., Ltd.


Zhongwei Jiang
Beijing NAURA Technology Group Co., Ltd.


Li Fei Sun
Lam Research


Chao Lv
Beijing NAURA Technology Group Co., Ltd.


Shijing Wang
Shanghai BangXin Semi Technology Co., Ltd.


Yuxuan Zhai
Institute of Microelectronics, Chinese Academy of Sciences


Lei Sun
Applied Materials China


Ling Wang
Ferrotec Technology Development (Shanghai) Co. Ltd


Jun Luo
Beijing NAURA Technology Group Co., Ltd.


Yang Ding


Litian Xu
Beijing NAURA Technology Group Co., Ltd.


Yuxing Yang
Jiangsu Leuven Instruments Co., Ltd.
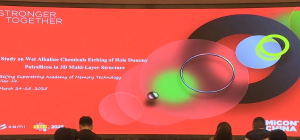

Jiao Jin
Beijing Superstring Academy of Memory Technology


Yoshiaki Yamada
Hangzhou Cobetter Filtration Equipment Co.,Ltd


Ahmad Hassan Siddique
Tsinghua University


Chenming Xu
Jiangsu Leuven Instruments Co., Ltd.


Chengxi Yao
Sungkyunkwan University


Zehua Hei
Beijing Superstring Academy of Memory Technology


Licheng Yang
Beijing NAURA Technology Group Co., Ltd.


Haiyang Lv
Advanced Micro-Fabrication Equipment Company Inc.


Fan Yu
Beijing NAURA Technology Group Co., Ltd.


Anton Kobelev
Suzhou STR Software Technology Co., Ltd
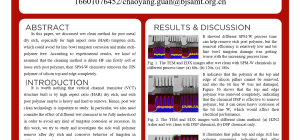

Chaoyang Guan
Beijing Superstring Academy of Memory Technology


Taojun Zhang
Jiangsu Leuven Instruments Co., Ltd.


Chun Gao
Lam Research


Quanzhi Long
Zhejiang University


Zhanduo Bai
Semiconductor manufacturing International (Beijing) Corporation


Yuying Liu
Lam Research


Xin Su
Advanced Micro-Fabrication Equipment Company Inc.


Jiahui Sun
Beijing Superstring Academy of Memory Technology


Jianhang Chen
Nexchip Semiconductor Corportion


Weiming Liu
Advanced Micro-Fabrication Equipment Inc.


Yang Wei
Nexchip Semiconductor Corporation


Gui Cong
Nexchip Semiconductor Corporation


Xuan Liu
Semiconductor Manufacturing North China (Beijing) Co.,Ltd.


Sichao Zeng
Applied Materials China


Jie Wang
Applied Materials China
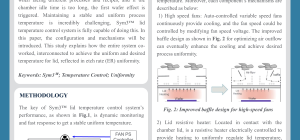

Tianyuan Liu
Applied Materials China
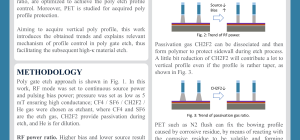

Xipeng Tong
Applied Materials China


Long Men
Applied Materials China


Wang Miao
Applied Materials China


Le Jiang
Applied Materials China


Fan Zhou
Applied Materials China


Kai Hu
Applied Materials China


Qunfeng Wen
Applied Materials China


Zhang Weiqiang
Applied Materials China


Chunlong Qiu
Applied Materials China


Songtao Lv
Applied Materials China


Difan Li
Applied Materials China
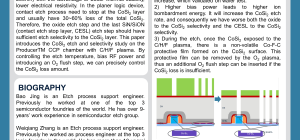

Bao Jing
Applied Materials China


Jianjun Liao
Applied Materials China


Kairong Cui
Applied Materials China
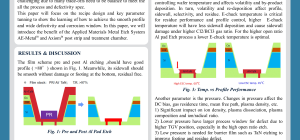

Fan Chen
Applied Materials China


Ping Zheng,
Applied Materials China


Jimmy Fu
Applied Materials China


Lijun Shan
Applied Materials China


Tongyao Zhao
Applied Materials China
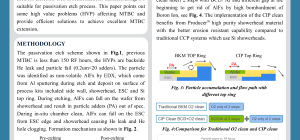

Jing Cao
Applied Materials China


Shuda Xu
Applied Materials China


Ziyue Xuan
Applied Materials China


Hanlin Cui
Applied Materials China


Longjie Yu
Applied Materials China


Caili Lang
Applied Materials China
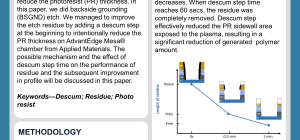

Jiajie Li
Applied Materials China
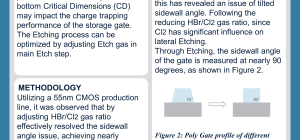

Wenyi Tang
Applied Materials China
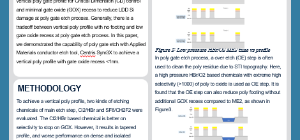

Lin Luo
Applied Materials China


Dongjiang Wang
Applied Materials China
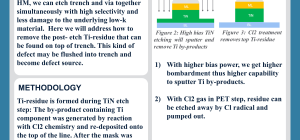

Rishuai Zheng
Applied Materials China


Zheng Ruan
Lam Research


Kevin Yao
Lam Research


Shipeng Gong
Lam Research


Rui Hu
Applied Materials China
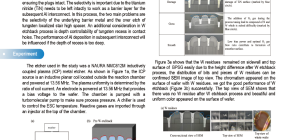

Haoran Song
Beijing NAURA Technology Group Co., Ltd.


Mengjiao Zhu
Beijing NAURA Technology Group Co., Ltd.
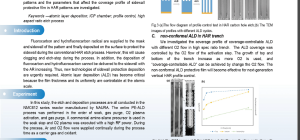

Li Zeng
Beijing NAURA Technology Group Co., Ltd.


Xuehua Wang
Beijing NAURA Technology Group Co., Ltd.


Yiman Ma
Beijing NAURA Technology Group Co., Ltd.


Guangzhao Yuan
Beijing NAURA Technology Group Co., Ltd.


Yu Hao
Beijing NAURA Technology Group Co., Ltd.


Teng Zhang
Beijing NAURA Technology Group Co., Ltd.
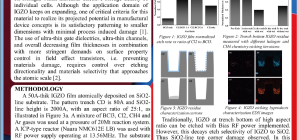

Run Zhang
Beijing NAURA Technology Group Co., Ltd.


Shun Yang
Beijing NAURA Technology Group Co., Ltd.
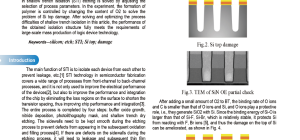

Yingjie Wang
Beijing NAURA Technology Group Co., Ltd.
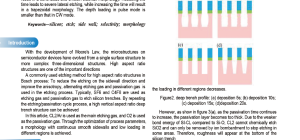

Yiming Ma
Beijing NAURA Technology Group Co., Ltd.


Guohui Jia
Beijing NAURA Technology Group Co., Ltd.


Chao Xu
Beijing NAURA Technology Group Co., Ltd.


Xiaoxia Meng
Advanced Micro-Fabrication Equipment Company Inc.


Yue Wei
Advanced Micro-Fabrication Equipment Company Inc.


Xiao Wei
Advanced Micro-Fabrication Equipment Company Inc.
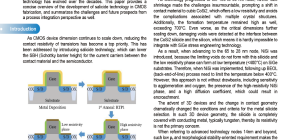

Yunlong Jia
Beijing NAURA Technology Group Co., Ltd.


Yuanwei Lin
Beijing NAURA Technology Group Co., Ltd.
© 2022 SEMI 云官网. All Rights Reserved.